Halvlederinspeksjon er et kritisk trinn for å sikre utbytte og pålitelighet i hele produksjonsprosessen for integrerte kretser. Som kjernedetektorer spiller vitenskapelige kameraer en avgjørende rolle – deres oppløsning, følsomhet, hastighet og pålitelighet påvirker direkte defektdeteksjon på mikro- og nanoskala, samt stabiliteten til inspeksjonssystemer. For å imøtekomme ulike applikasjonsbehov tilbyr vi en omfattende kameraportefølje, fra storformat høyhastighetsskanning til avanserte TDI-løsninger, bredt distribuert innen waferdefektinspeksjon, fotoluminescenstesting, wafermetrologi og emballasjekvalitetskontroll.
-

Gemini 8KTDI Bakbelyst TDI-sCMOS-kamera
Spektralområde: 180–1100 nm
Typisk QE: 63,9 % @ 266 nm
Maks. linjehastighet: 1 MHz @ 8/10 bit
TDI-trinn: 256
Datagrensesnitt: 100G / 40G CoF
Kjølemetode: Luft / VæskeVis mer -

Dhyana 9KTDI Pro Bakbelyst TDI-sCMOS-kamera
Spektralområde: 180–1100 nm
Typisk QE: 50 % @ 266 nm
Maks. linjehastighet: 600 kHz @ 8/10 bit
TDI-trinn: 256
Datagrensesnitt: QSFP+
Kjølemetode: Luft / VæskeVis mer -

Dhyana 9KTDI Bakbelyst TDI-sCMOS-kamera
Spektralområde: 180–1100 nm
Typisk QE: 38 % @ 266 nm
Maks. linjehastighet: 510 kHz @ 8 bit
TDI-trinn: 256
Datagrensesnitt: CoaXPress 2.0
Kjølemetode: Luft / VæskeVis mer
-
Kan EMCCD erstattes, og ville vi noen gang ønske oss det?
 5460
5460  2024-05-22
2024-05-22 -
En utfordring med områdeskanning? Hvordan TDI kan 10 ganger bildeopptaket ditt
 5664
5664  2023-10-10
2023-10-10 -
Få fart på lysbegrenset opptak med Line Scan TDI Imaging
 7078
7078  2022-07-13
2022-07-13
-
Sporing av lysfyr i svært grumsete vann og anvendelse ved undervannsdokking
 1000
1000  2022-08-31
2022-08-31 -
Neurittvekst av trigeminusganglionneuroner in vitro med nær-infrarødt lysbestråling
 1000
1000  2022-08-24
2022-08-24 -
Høytemperaturtolerante sopper og oomyceter i Korea, inkludert Saksenaea longicolla sp. nov.
 1000
1000  2022-08-19
2022-08-19

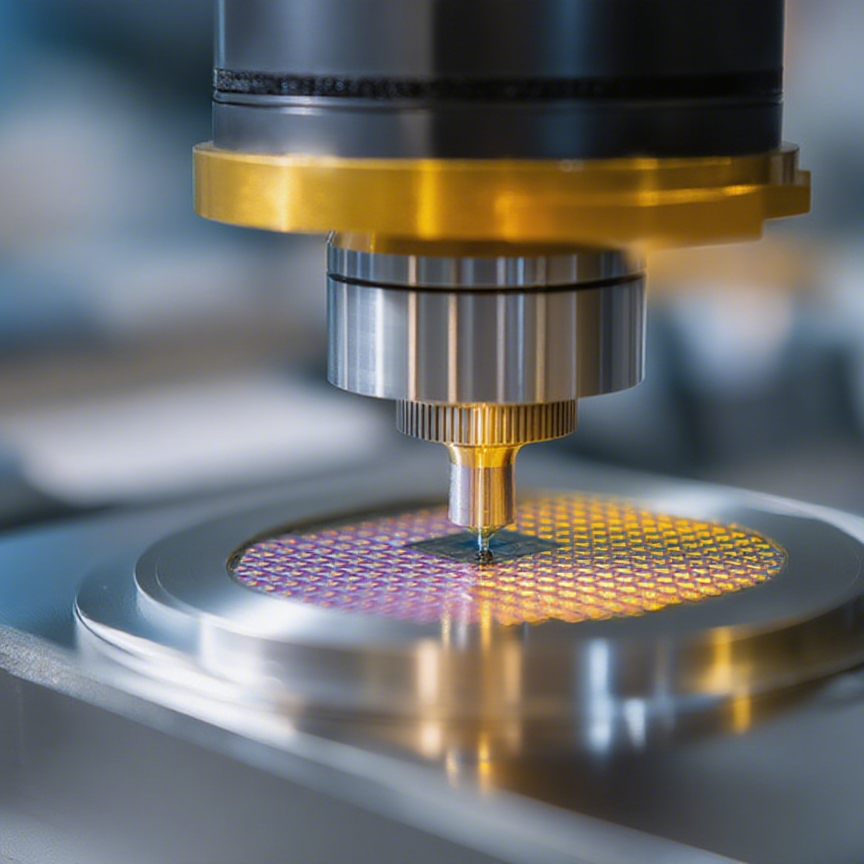

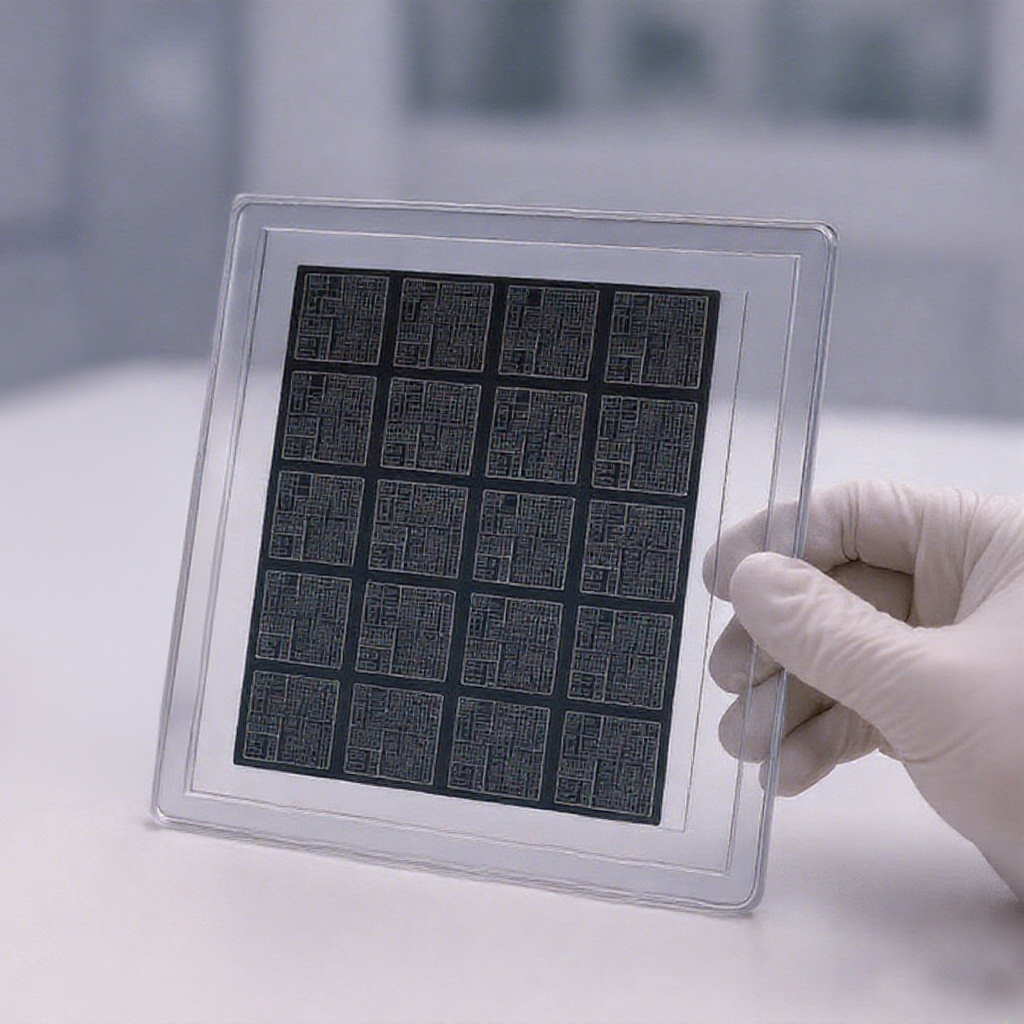

 5460
5460